
迈入SDV时代为智驾算力“降温” ―VC均热板与TIM材料如何共筑起一道散热长城―
前言:
随着汽车工业迈入“软件定义汽车(SDV)”的时代,车辆的电子电气架构正在经历一场深刻的变革。从分布式ECU(电子控制单元)到集中式DCU(域控制器),高阶自动驾驶和智能座舱的落地对算力提出了指数级的需求 。
然而,算力提升的背后是功耗的飙升。智能驾驶域控制器作为自动驾驶的“大脑”,其内部集成的SoC芯片功耗已从过去的几十瓦飙升至几百瓦甚至更高。如何将这些高热流密度芯片产生的热量高效排出,保证芯片在苛刻的车规级环境下长时间稳定运行,成为摆在每一位“汽车人”面前的一道屏障。在这场散热攻坚战中,TIM(Thermal Interface Material,热界面材料) 与VC(Vapor Chamber,均热板)的组合扮演着承载系统散热的基石角色。

一、 Zonal E/E集中化架构下的“热”挑战
现代DCU将原本分散的多个ECU功能高度集中,这导致两个显著的散热难题:
- 功率密度飙升:高算力AI芯片(如NVIDIA Orin、华为昇腾Ascend)在如同指甲大小的面积上集成了数百亿个晶体管,产生极高的热流密度。传统的依靠空气对流的散热方式,在面对如此集中的热源时显得力不从心 。
- 空间与可靠性的双重挤压:车载环境要求DCU必须在有限、密闭且充满振动的空间内工作。散热路径上的任何微小空隙,都会成为热量传递的“断路开关”。芯片与散热器(如VC均热板、散热鳍片)之间看似光滑的接触面,在微观下充满了凹凸不平的空气隙。空气其极低的导热系数(仅约0.026 W/m·K)是导致散热效率大打折扣的关键因素。
因此TIM导热填缝材料和VC均热板的选型与匹配直接影响到整个系统的散热效率。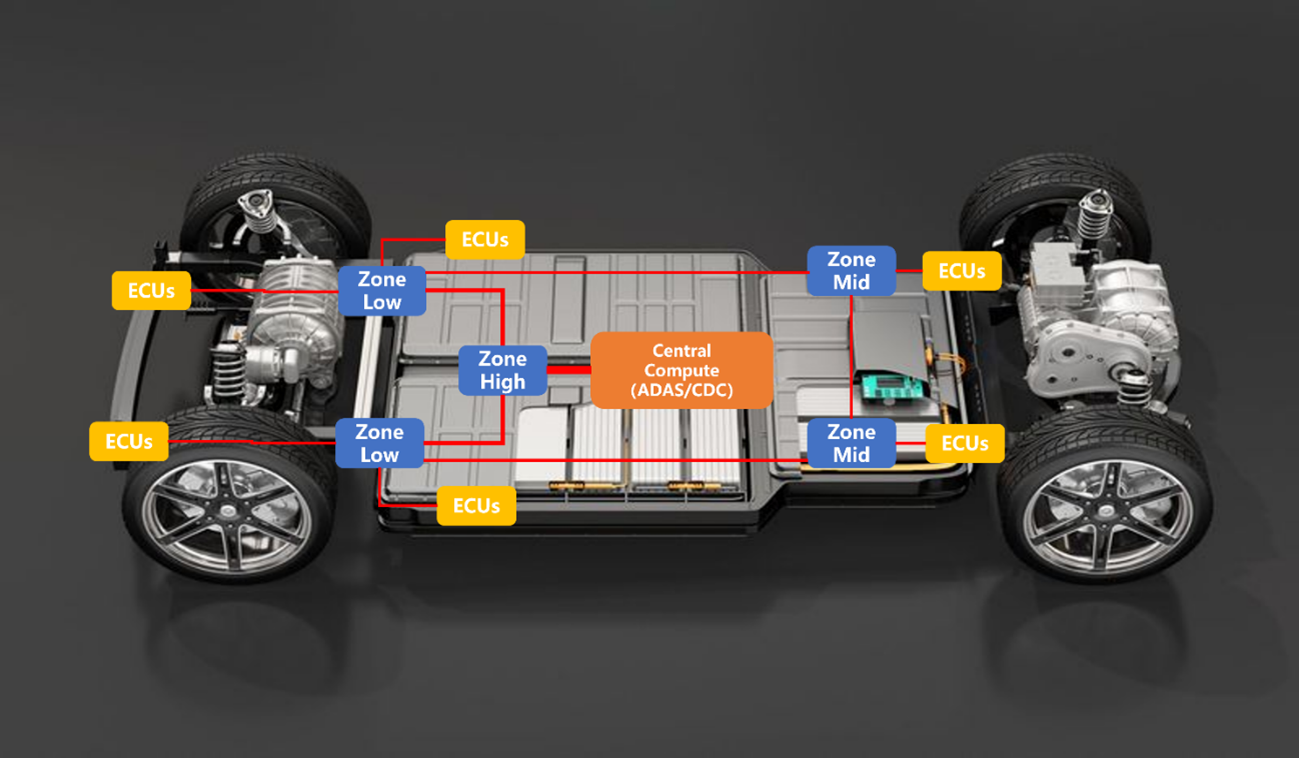
二、TIM与VC的角色定位:各司其职,缺一不可
・VC均热板:热量的“高速搬运工”
VC均热板的核心使命是“均温与扩展”。
当热量从芯片顶部传递到VC板时,VC内部的工作流体会迅速蒸发,将局部集中的点热源瞬间扩散到整个板面。它的价值在于:将“炙热的点”变成“温暖的面”。一块等效热导率高达5000-20000 W/m·K的VC,能够让后方的大面积散热鳍片或冷板被充分激活,避免出现“局部过烫、周围闲置”的尴尬局面。
・TIM导热填缝材料:界面的“微观桥梁”
TIM导热填缝材料的核心使命是“填充与导通”。
无论VC板的底面打磨得多么光滑,在微观尺度下,它与芯片顶盖之间依然存在由空气填充的凹凸空隙。而空气是热量的绝缘体。导热填缝材料的任务,就是以最低的热阻填充这些微观空隙,在芯片与VC之间架起一座看不见的“热桥”。没有它,VC的性能再强悍,也接触不到芯片的热量。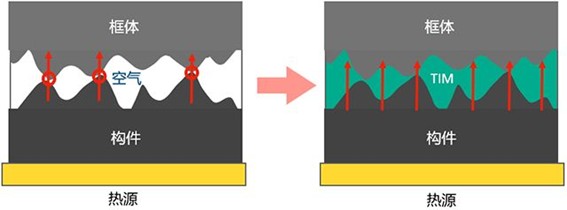
三、协同效应:1+1 > 2的热管理哲学
当VC均热板与导热填缝材料真正实现协同工作时,它们会释放出远超单一元件性能叠加的惊人效果。
- 从“点”到“面”再到“散”的完整链路:
- 第一步:芯片热源 → TIM(微观导出)
芯片产生的热量首先传递给导热填缝材料。高性能的TIM(如导热相变化材料PCM或超薄导热界面材料TPM)以其极低的接触热阻,将热量从芯片顶盖高效地“吸”出来,并完整地传递给上方的VC均热板。 - 第二步:TIM → VC均热板(宏观扩展)
热量进入VC均热板的蒸发区。VC内部发生相变传质,蒸汽以接近声速的速度将热量从局部热点迅速“搬运”到整个冷凝面。原本聚集在芯片正上方的热量,被均匀地摊铺开来。 - 第三步:VC均热板 → 散热鳍片/冷板(最终释放)
经过VC均温后的热量,以大面积的均匀热流形式传递给后级的散热鳍片(风冷)或冷板(液冷),最终被流动的空气或冷却液带走。
- 共同应对芯片翘曲的“热-力”挑战
大尺寸芯片在高温工作或低温启动时,不可避免地会产生翘曲。这是DCU散热设计中的“隐形杀手”。
- TIM的角色: 高内聚力的导热填缝材料(尤其是TPM或相变材料)能够适应芯片的形变,始终保持与芯片和VC板的紧密贴合,不会因翘曲而产生脱层或空隙。
- VC的角色: 高性能VC均热板本身具有一定的柔性和结构强度,能够在一定程度上吸收和适应芯片的翘曲应力,同时保持自身的热输运性能不衰减。
两者共同构成了一套“柔-刚结合”的缓冲系统,确保在恶劣的车载工况下,散热界面始终稳定可靠。
- 最大化散热资源的利用率
如果没有VC均热板,即使TIM的导热系数再高,热量也只能在一个小面积内传导,后级散热器的绝大部分区域处于“闲置”状态。
如果没有高性能TIM,即使VC的均温能力再强,它也无法有效地从芯片获取热量,因为界面上的空气隙会成为“热断路”。
只有两者结合,才能让每一片散热鳍片都发挥作用,让每一滴冷却液都带走热量。 这是对散热资源的最大化利用,也是高功率密度DCU设计的必然选择。
四、VC与TIM的选型匹配:如何打造出完整的散热链路?
- 匹配热阻与热输运能力
- TIM材料: 关注其界面热阻和长期可靠性。对于高功率密度的智驾芯片,推荐选用导热相变化材料(PCM) 或超薄导热界面材料(TPM),它们在极低的键合厚度(BLT)下实现高效导热,且具备优异的耐泵出、耐老化性能。
- VC材料: 关注其等效热导率和承载功率。确保VC的极限热输运能力高于芯片的最大功耗,并留有足够的设计余量。
- 界面匹配与压力兼容性
TIM的导热性能往往与安装压力相关。VC均热板的表面平整度和刚度会影响TIM的实际压缩状态。设计时需确保:
- VC板的平面度满足TIM的设计要求。
- 整个模组的锁付压力能够使TIM充分填充界面,同时又不会超出VC板的承受范围。
- 车规级可靠性验证
- 冷热冲击测试:验证材料在极端温差下是否分层、失效。
- 高温高湿测试(双85):验证材料在潮湿环境下的稳定性。
- 振动与机械冲击测试:验证界面在长期振动下是否保持紧密接触。

★TIM类产品定位图:
・导热垫片(Sheet):
有机硅系~24W/m-K
非硅系~17W/m-K
9W/m-K超高绝缘系列(绝缘击穿电压 20KV/㎜)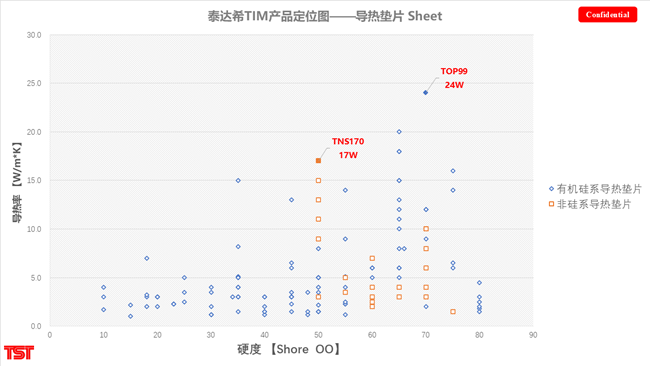
・导热凝胶(Gel):
有机硅系~12W/m-K
高流速系列(挤出速度>60g/min)
・导热硅脂(Grease):
有机硅系~8W/m-K
非硅系~6W/m-K
低键合厚度(BLT<50um)
・导热膏(Putty):
有机硅系~13W/m-K
非硅系~10W/m-K
超低密度系列(<2.8g/㎝³)
可在90°垂直条件下使用(抗垂流性)
★VC均热板新产品介绍:
FGHP具有水平方向10,000 W/m-k、垂直方向500 W/m-k(400 K时的数值,40~60℃为转变温度)的导热系数,和高达220°C(可245°C无铅焊接)的耐热温度。由于热扩散能力优异,因此不会产生热点。可支持600 W以上的高输出热源的加热(支持φ120 mm)。厚度薄至1.8至2.2 mm,可适用于小型设备。
FGHP支持高效率散热,解决因发热引起的问题。
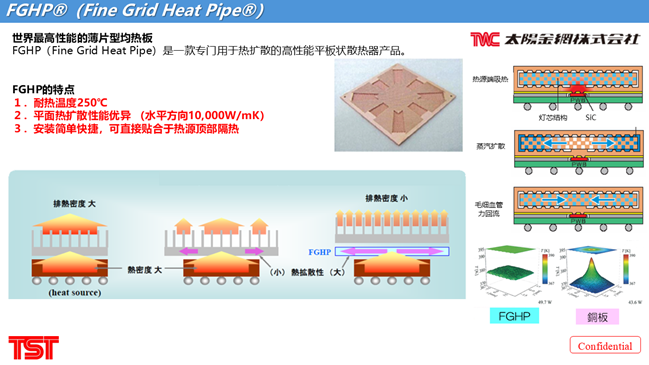

FGHP®的最大特点:将局部的热源以「面方向」瞬间扩散传输
六、公司介绍
泰达希科技(上海)有限公司是日本太阳金网株式会社100%出资在中国上海设立的现地法人。公司于2002年9月在中国(上海)自由贸易试验区成立,此后开展面向中国国内及海外的产品销售和贸易业务。
★业务内容
热对策产品(Thermal Management Products)
热管理・散热相关产品(散热片、散热器、均热板、导热凝胶、导热硅脂等)
EMI/电磁屏蔽相关产品
包括电磁干扰(EMI)对策产品及屏蔽材料,为电子设备的热及电磁环境对策提供解决方案
★各类配套设备
通过配备相关测试设备,结合专业开发团队设计测试方案,可以快速响应客户的定制化测试需求。
★特色服务
泰达希科技(上海)从设计初期阶段开始,提供从TIM材料选定、试作、性能评估到量产导入的一站式服务。
为各行业中特定用途条件下所带来的散热课题提供解决方案。让客户不单单是从产品目录中了解材料特性,通过尽可能去模拟再现实装方法,提供材料选型支援,以及统一测试条件便于产品间的数值化对比(测试对象也包括我司产品以外的材料),从设计初期到量产阶段提供全面支持。
除此之外,我司也可以通过提供热测试方法和热仿真等技术支持,为客户节省在开发阶段所需的时间和人力成本,为提供流畅的开发测试服务做出贡献。

七.联系方式
联系人:Felix Ma(市场销售)
手机 :13916629101(微信同号)
E-mail:yunqi.ma@tst-net.com.cn



